碳化硅功率器件
碳化硅功率器件作为新一代功率半导体器件,以其优异的特性获得了广泛的应用,同时也对其动态特性测试带来了挑战,现阶段存在的主要问题有以下三点:
一点是,每个人都在讲碳化硅器件动态特性测试很难,但动态特性到底包含哪些,测试难点是什么?并没有被系统地梳理过,也没有形成行业共识。
第二点是,得到的测试结果是否满足需求,或者说“测得对不对”,还没有判定标准。这主要源自大部分工程师对碳化硅器件动态特性还不够了解,不具备解读测试结果的能力。
第三点是,芯片研发、封装设计与测试、系统应用等各个环节的人员之间掌握的知识存在鸿沟,又缺乏交流,会导致测试结果能发挥的作用非常有限,同时下游的问题不能在上游就暴露并解决,对加快产业链闭环速度造成负面影响。
Part.1

我们先对碳化硅器件动态特性进行简单的定义和介绍。

提到动态特性,大家的一反应一定是开关特性,这确实是功率器件的传统核心动态特性。由于其是受到器件自身参数影响的,故器件研发人员可以根据开关波形评估器件的特性,并有针对性地进行优化。另外,电源工程师还可以基于测试结果对驱动电路和功率电路设计进行评估和优化。
当SiC MOSFET应用在半桥电路时就会遇到串扰问题,可能会导致桥臂短路和栅极损伤。同样的,器件研发人员和电源工程师都需要根据串扰测试结果进行下一步工作。SiC MOSFET的开关速度快、栅极负向耐压能力差,使得串扰问题是影响SiC MOSFET安全运行的棘手问题和限制充分发挥其高开关速度的主要障碍之一。同时,串扰问题是开关过程的产物。所以我们认为串扰特性应该算作碳化硅器件动态特性的一部分,这样既能体现开关过程的影响,又能体现现阶段碳化硅器件相对于硅器件的特殊性。
在整流输出和MOS-Diode桥式电路中往往都会出现SiC Diode或SiC MOSFET体二极管的反向恢复过程,发生反向恢复也是与开关过程伴生的,也是功率二极管的传统核心动态特性。
综上所述,碳化硅器件的动态特性应该包含开关特性、串扰特性和反向恢复特性三个部分。
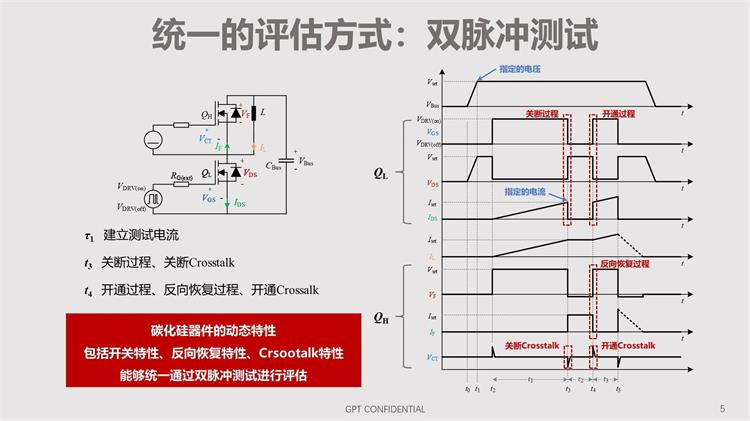
刚才我们提到,串扰和反向恢复是与开关过程伴生的,这也就意味着,碳化硅动态特性的三个部分可以采用统一的测试方法,即双脉冲测试。
双脉冲测试采用的是电感负载半桥电路,右边是测试波形示意图。可以看到,驱动电路向QL发送双脉冲控制信号,各个波形都呈现出两个脉冲的形态,故称之为双脉冲测试。QL在t2时刻开通,t3时刻关断,此时可以观测到QL的关断过程和QH的关断串扰。QL在t4时刻再次开通,此时可以观测到QL的开通过程和QH的开通串扰和反向恢复。
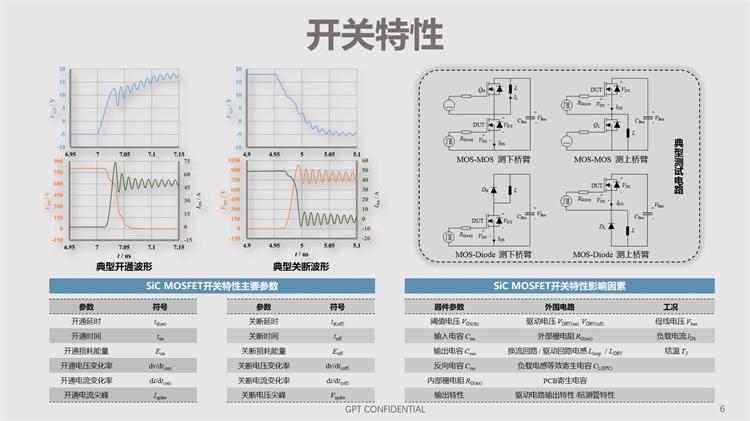
开关波形包括栅源极电压VGS、漏源极电压VDS、漏源极电流IDS。基于得到的开通和关断波形,可以获得很多开关特性的参数,包括:开关延时、开关时间、开关能量、开关速度、开通电流尖峰、关断电压尖峰。
根据陪测管类型和被测器件的位置,可以得到四种测试电路,根据需求和实际应用情况选择即可。
开关特性受到多方面因素的影响,包括器件参数、外围电路和工况,这里就不再详细展开了。但这一点对我们有两点启发:一是,器件研发人员可以将开关过程测试结果和器件其他参数综合在一起进行评估,对器件参数的优化有指导意义;第二是,即使是同一型号的器件,其开关特性并不固定不变的,这也就是为什么在不同的测试平台上测得的结果差异很大,往往与规格书上的数值也存在很大偏差。
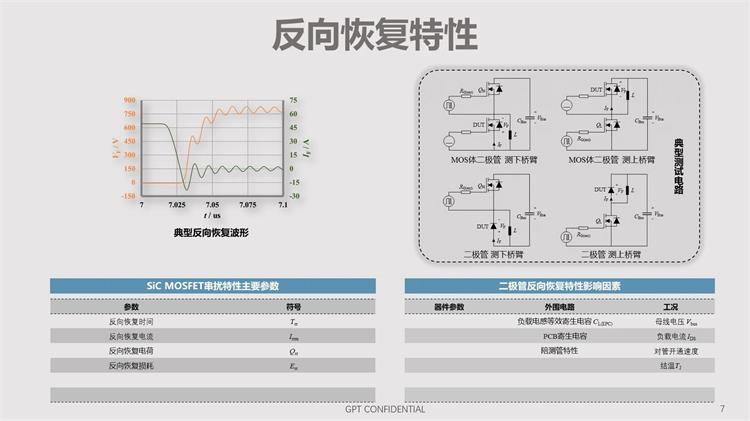
反向恢复波形包括端电压VF、端电流IF。基于得到的反向恢复波形,可以获得的反向恢复特性的参数包括:反向恢复时间、反向恢复电流、反向恢复电荷、反向恢复能量。与开关特性一样,有四种反向恢复特性测试电路,器件参数、外围电路和工况也同样会影响其反向恢复特性的测试结果。
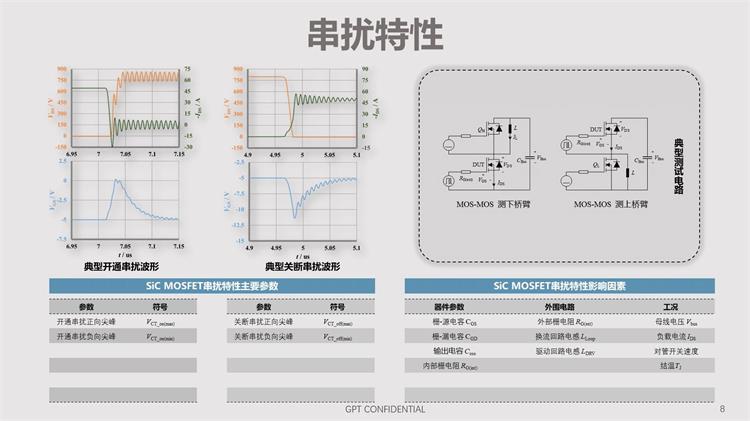
串扰波形包括栅源极电压VGS,而漏源极电压VDS、漏源极电流IDS能够辅助串扰过程的分析。基于得到的串扰波形,可以获得的串扰特性的参数是串扰正向和负向尖峰。由于串扰只发生在MOS-MOS半桥电路中,故只有两种测试电路,与开关和反向恢复测试电路不同。而串扰特性也同样受到了器件参数、外围电路和工况的影响。
Part.2

刚才我们提到,现阶段遇到的一个难题是“如何判断测试结果是否符合要求”,而要求一定来自具体的测试场景和测试需求。

需要进行碳化硅器件动态特性测试的场景非常多:在器件厂商,在进行产品调研分析、工程样品验证、规格书制作时需要测试;在封装厂商,在进行封装设计、出厂测试、裸片筛选时需要测试;在系统应用厂商,在进行来料检测、器件认证、器件选型、损耗计算、驱动设计、功能调试时需要测试;在科研机构,无论是做器件研究还是应用研究,也都需要进行测试。可以说,碳化硅器件的动态特性测试横跨产业和学术领域、涵盖器件产业链的各个环节、贯穿器件完整生命周期,从这一点上也能够看出其具有重要意义。

在针对每一个测试需求给出对测试结果的要求之前,我们先回到测量的本质要求,即准确度和精准度。
测试结果越接近芯片上的实际值,即上方的红点越接近圆心,则其准确度越高。相同的测试条件下进行多次测量的一致性越好,即上方的红点越集中,则精准度越高。按照准确度和精准度,可分为四种情况。低准确度、低精准度和高准确度、低精准度的测试结果毫无价值;低准确度、高精准度比较容易达到,这样的测试结果适合用于考察器件的一致性;高准确度、高精准度的测试结果可用于器件特性分析、损耗计算、封装设计、串扰抑制研究。
在关注动态过程时,准确度的优先级更高;在关注器件参数一致性时,精准度的优先级更高。研发、应用、生产对动态测试的要求依次从高到低降低。

根据前面的分析,表格中给出了各产业环节中的不同测试场景需要进行的碳化硅器件动态特性测试项目及相对的要求高低,星号越多则要求越高。
在器件研发、功率模块设计以及学术研究时,非常关注动态特性的过程,对波形的形态和幅值斤斤计较,故要求高,准确度和精准度的要求都是5颗星。而在出货测试和来料检验时,只要测试足够稳定、偏差很固定,测试结果在给定的范围内即可,其要求低,精准度和精准度的要求都是1颗星。在使用SiC MOSFET时,串扰问题的影响非常大,则对其准确度的要求是5颗星。其他场景就不再一一列举了。
Part.3
接下来我们一起看看测试技术面临的挑战

双脉冲测试系统的结构很简单,主要部件包括测试电路、负载电感、信号发生器、辅助电源、直流电源、示波器、电压探头以及电流传感器探头。测试技术的挑战都可以转化为对测试系统中各个部件的要求。

测试电路的作用是向被测器件提供运行条件,确保其工作在正确的工况下。
测试电路是否满足要求的评判标准是在确定测量环节无误和被测器件特性正常的情况下,测得波形不存在异常,如关断电压尖峰超过器件电压等级、器件误导通、出现不符合理论的震荡等等现象。
这就需要测试电路在以下几点进行优化:主功率回路电感需要尽量小,以免关断电压尖峰超过器件耐压值而导致器件损坏;驱动回路电感需要尽量小,以免发生不必要的驱动波形震荡;驱动电路需要能够方便地进行改变参数,其电流输出能力需要满足要求,同时需要考虑增加各类保护功能;负载电感需要做到电阻小、等效并联电容小;母线电容需要控制在合理范围内。

测量仪器的作用是获取被测器件上所关注的电压和电流波形。
测量仪器是否满足要求的评判标准是在测试电路符合要求、被测器件特性正常、测量仪器使用方法正确的情况下,测量结果满足此时测试需求对测试结果的要求。因为是没有真实值作为评判标准,只能通过正确选择仪器类型和指标,采用正确的使用方法和连接方式,尽量避免由测量仪器导致的偏差,同时通过分析波形的主要特征的合理性进行判断。

下边给出的波形说明了选择合适的测量仪器重要性。例如,测量电流时,使用罗氏线圈测得的波形相比于使用同轴电阻测得的波形,上升速度慢、幅值也偏低,这就是罗氏线圈的带宽过低,不能满足碳化硅高开关速度的需求。测量上桥臂器件驱动波形时,采用高压差分探头测得的结果呈现出欠阻尼和过阻尼的状态,只有采用光隔离探头才得到方波状驱动波形,这是由于光隔离探头具有更高的共模抑制比,适合测量含有高压高速跳变的共模电压的驱动波形。
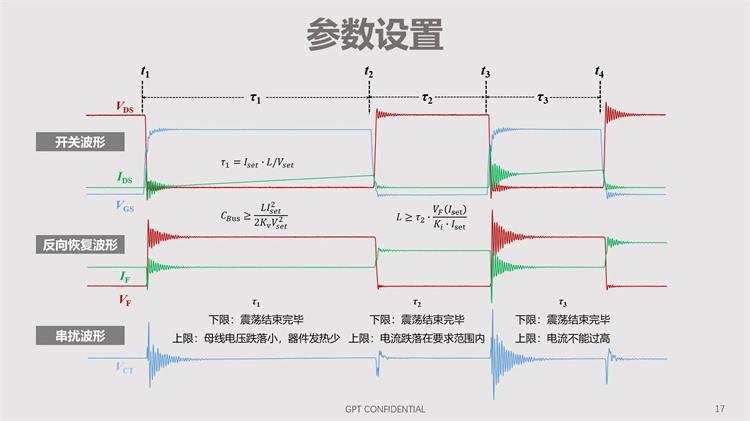
另外一个没有形成共识,但受到大家关注的就是双脉冲测试参数如何设定。不同规格的器件,测试条件不同,参数设定自然不同,但依然可以提出一些原则。
双脉冲型号宽度有一脉宽τ1、第二脉宽τ3、脉冲间隔τ2。它们的时长下限都是需要满足波形震荡完全结束,以能够完整观测波形,且不影响接下来的动态过程。一脉宽τ1的上限制约条件是母线电压跌落小,器件自发热少。脉冲间隔τ2的上限制约条件是电流跌落在要求范围内。第二脉宽τ3的上限制约条件是电流不会过高导致关断电压尖峰过高。
这里需要注意的是,一脉宽τ1时长可由测试电流、负载电感、测试电压确定。母线电容的小值由负载电感、测试电流、母线电压、允许的母线电压跌落比例确定。负载电感由脉冲间隔τ2、续流二极管压降、测试电流、允许的测量电流跌落比例确定。由此可见,一脉宽τ1、脉冲间隔τ2、母线电容、负载电感、测试电压和电流之间是互相制约的,这也使得确定双脉冲测试参数的过程会比较复杂。
Part.4

一个问题是有关测量准确度的,也是我们一直忽略的问题,那就是测量点间寄生参数的影响。

SiC MOSFEF分立器件常见的封装形式是TO-247-4PIN和TO-247-3PIN,通过其内部结构图可以看出,两者的差异是TO-247-4PIN有一根专用于驱动的KS引脚,实现了主功率回路和驱动回路的解耦,而TO-247-3PIN是主功率回路和驱动回路共用S引脚。
在测量分立器件电压时,电压探头只能夹在引脚上,那么一部分引脚、bonding线、SiC MOSFET芯片内部栅极电阻都被包含进了电压测量点之间。我们通过下边的等效电路就可以看出它们的影响了。需要注意的是VGS是CGS的端电压,是用于做分析时实际所需要的驱动波形,是真正有用的信号,VGS(M)是我们能测得的结果,它们之间存在寄生参数,VDS和VDS(M)同理。而驱动电流IG、负载电流IDS会在这些寄生参数上产生压降,也被电压探头测得,与芯片上的真实信号相加,共同构成了测量结果。
可以很容易得到测量值与真实值之间的关系,如下边的公式所示。需要注意的是,TO-247-4PIN和TO-247-3PIN受寄生参数的影响的不同在于,TO-247-3PIN器件电压测量结果会受到IDS在S极封装寄生电感上产生的电压的影响,而TO-247-4PIN器件不会。其原因就是刚刚提到的两者结构上的差异。

对于功率模块,电压探头同样只能接在模块的端子上,不能直接接触芯片。这里有四个功率模块,打开其外壳可以观察到其内部结构。可以看到,从芯片到模块端子有金属走线和bonding线,距离端子越远的芯片,走线越长。另外,为了避免并联的芯片之间发生栅极震荡,会额外给每颗芯片单独增加一颗栅极电阻。以上这些电感和电阻上的电压也都会被计入测量结果中。
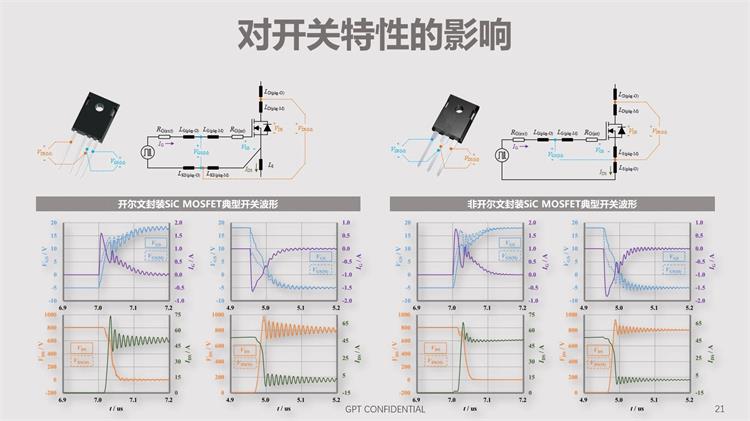
先来看一下寄生参数对开关特性的影响。实线为芯片上真实值,虚线为测量结果,可以看到实线和虚线具有明显差异。
在开关过程之初,VGS虚线测量结果在一开始呈现几乎垂直变化,而不是CR充放电过程;在开通过程,当VGS虚线测量结果超过阈值电压时,仍然没有电流流过;在关断过程,当VGS虚线测量结果低于阈值电压,IDS仍然很高。这些都是与理论严重不符的,足以证明VGS虚线测量结果的错误。而对于TO-247-3PIN器件,VGS虚线测量结果出现一个向上的尖峰,使用过3PIN器件的工程师一定被这个尖峰折磨过,担心其影响器件栅极的安全。但这个尖峰并不存在于芯片上,是由于IDS快速上升在S极封装寄生电感上产生的电压的被误计入了。
由此可见,由于寄生参数的影响使得测得的波形偏离了真实的波形,如果基于错误的测量结果进行开关过程分析、损耗计算、安全判定,那就把会把我们带进沟里。
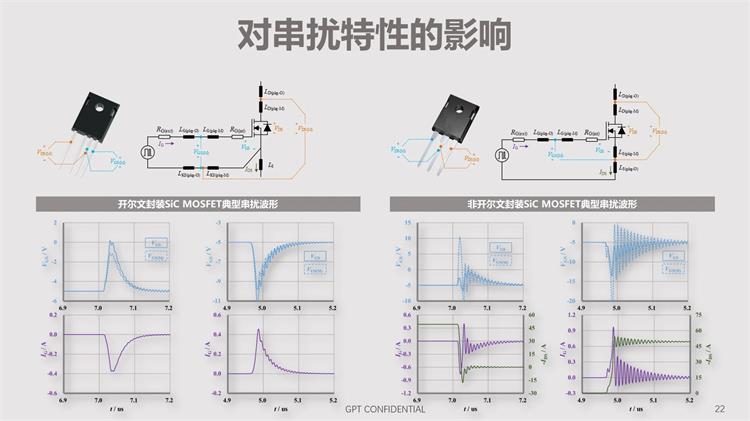
现在我们来看一下寄生参数对串扰特性的影响。对于TO-247-4PIN器件,VGS虚线测量结果总是低于VGS实线芯片真实值。也就是说,测量结果低估了串扰的严重程度。对于TO-247-3PIN器件,VGS虚线测量结果与VGS实线芯片真实值之间存在巨大偏差,存在非常夸张的震荡,按VGS虚线测量结果分析,既会发生桥臂直通,也会发生栅极击穿。
由此可见,由于寄生参数的影响,错误的测量会使我们对串扰情况做出误判,而TO-247-3PIN器件更为严重。这也是更加推荐使用TO-247-4PIN器件的原因,测得的开关和串扰波形与芯片真实值的偏差不会像TO-247-3PIN器件那么离谱。

测量结果是否接近芯片上的真实值,属于测量准确度的一方面。当我们关注开关过程、串扰的值时,就需要尽量排除掉寄生参数的影响,获得芯片上真实的波形。

我们再回到准确度和精准度上来。在为了获得更靠谱的碳化硅器件动态过程波形的道路上,广大工程师和科研工作者做了很多努力:提高测量系统带宽、提高探头共模抑制比、改善测量连接方式都是在准确度上做工作;提高测量仪器稳定性、提高硬件电路稳定性、提高测试点连接稳定性是在精准度上做工作。现在业内的状态是,精准度高、准确度半高的状态,还差排除点测量点间寄生参数的影响这一步骤。

对以上内容进行小结,我们得到四个重要结论:
1)碳化硅功率器件动态特性包括:开关特性、反向恢复特性、串扰特性
2)动态特性测试需求种类多样,对准确度和精准度要求具有明显差异
3)测试电路板和测量仪器是获得正确测试结果的保障,需合理设计和选型
4)测量点间寄生参数是获得芯片上真实电压信号的瓶颈,具有显著的负面影响